露光中(紫外線)にマスクを移動させることで、レジスト表面への露光エネルギー分布を制御し、任意の曲面や傾斜を有する三次元微細構造体が製作できる露光装置です。
主な特長
- 独自のミラー・レンズ光学系採用により全面均一照射を実現。
- ギャップセンサによる非接触・面内均一なギャップと、多層露光が可能な顕微鏡、X,Y,θ軸ステージのアライメントシステムを装備。
- Moving UV mask法(ピエゾステージを用いて露光中にマスクを微細移動させる)により厚膜レジストの側壁傾斜角度が制御でき、三次元微細構造体の形成が可能。
レジスト膜厚50μmのパターン例
L/S=50μm
マスク移動量=20μm
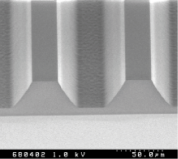
Dot=Ø50μm
マスク移動量=Ø25μm
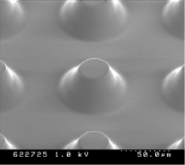

主な仕様
| MUMシリーズ | ||
|---|---|---|
| マスクサイズ | Max 9″ x 9″ x t3.0 mm | |
| 基板サイズ | Max Ø8″(Wafer) | |
| 光源 | 超高圧水銀灯:500W or 1kW | |
| 外形寸法および重量 | 本体寸法 | W2120 x D1305 x H1850 mm |
| 本体重量 | 640kg | |
※基板サイズや水銀灯のワット数、特殊仕様のご相談を受け付けております。




